Автоматический оптический анализ формы пластин и фотошаблонных заготовок серии WafoM 40 может автоматически измерять толщину пластин, шероховатость поверхности, микро-нано- трехмерную морфологию в одной измерительной системе. Спектральная конфокальная технология используется для измерения толщины кремниевых пластин, TTV, LTV, BOW, WARP, шероховатости поверхности и других параметров и одновременно для генерации диаграммы Mapping. Технология интерферометрии белого света используется для бесконтактного сканирования поверхности пластин.
Позволяет измерять различные типы поверхности объектов: от гладких до шероховатых, с коэффициентом отражения от низкого до высокого, а также толщину, шероховатость, плоскостность, микрогеометрические контуры, кривизну деталей на уровне от нанометра до микрометра. Предоставляет более 300 видов 2D и 3D параметров в качестве критериев оценки в соответствии с четырьмя основными отечественными и зарубежными стандартами ISO/ASME/EUR/GBT.
Сфера применения
Измерение толщины и угловатости кремниевой пластины без схемы
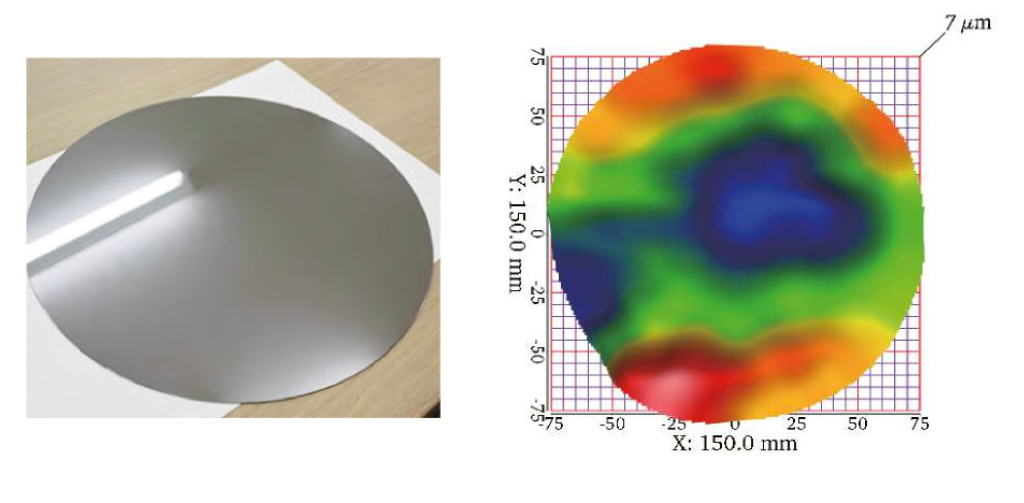

Благодаря бесконтактному измерению осуществляется восстановление трехмерной морфологии верхней и нижней поверхностей кремниевой пластины. Мощное ПО для анализа измерений предоставляет стабильный расчет толщины и шероховатости кремниевой пластины, ее общее изменение по толщине (TTV). Обеспечивает действенную защиту целостности пленки или изображения кремниевой пластины.
Сфера применения
Измерение шероховатости кремниевых пластин без схемы
3D-изображение поверхности кремниевой пластины после грубого и тонкого шлифования в процессе утончения полупроводниковой пластины. Используются числовые значения шероховатости Sa и стабильность числового значения многократных измерений для предоставления обратной связи о качестве обработки. Для утонченной полупроводниковой пластины, измеренной в условиях сильного шума в производственном цехе, шероховатость кремниевой пластины тонкого шлифования составляет около 5 нм. Повторяемость, рассчитанная на основе 25 данных измерений, составляет 0,046987 нм, стабильность измерений высокая.